
AI办事器海潮席卷全球,带动AI加快芯片需求。DRAM要道性家具HBM异军突起,成为了半导体下行周期中逆势增长的表象线。业界以为,HBM是加快夙昔AI本领发展的要道科技之一。
现代电子狡计机的性能推崇依赖于中央处理器(CPU)和动态立时存取存储器(DRAM)内存的协同配合,在冯·诺伊曼狡计机架构中,狡计处理单位证据指示从内存中读取数据,完成狡计处理后将数据存回内存。
先进的DDR4内存主频为2666~3200MHz,带宽为6.4GB/s。在高性能狡计、数据中心、东说念主工智能(AI)欺诈中,顶级高算力芯片的数据蒙眬量峰值在数百TB/s级别,但主流DRAM内存或显存带宽一般为几GB/s到几十GB/s量级,与TB/s量级还有较大差距。
DRAM内存带宽仍是成为了制约狡计机性能发展的进犯瓶颈,即所谓隔断性能进步的“内存墙”。
针对内存高带宽、大容量、低功耗的需求,从2013年运行,国际电子元件工业斡旋会(JEDEC)先后制定了3代、多个系列版块的高带宽存储器(HBM、HBM2、HBM2E、HBM3)规范。
HBM的3D堆叠结构
HBM堆叠结构如图1所示,包含多层DRAM芯片和一层基本逻辑芯片。4层或8层以至更多层数的DRAM芯片以堆叠体式整合在沿途,不同DRAM芯片之间以及DRAM芯片与逻辑芯片之间用TSV和微凸块本领达成通说念陆续。每个HBMDRAM芯片可通过多达8条通说念与外部相连,每个通说念可单独探听1组DRAM阵列,通说念间访存相互沉寂。
逻辑芯片可胁制DRAM芯片,并提供与胁制器芯片陆续的接口,主要包括测试逻辑模块和物理层(PHY)接口模块,其中PHY接口通过中间介质层与CPU/图形处理器(GPU)/片上系统(SoC)平直高速连通,平直存取(DA)端口提供HBM中多层DRAM芯片的测试通说念。
中间介质层通过微凸块陆续到封装基板,从而造成2.5D的SiP系统。
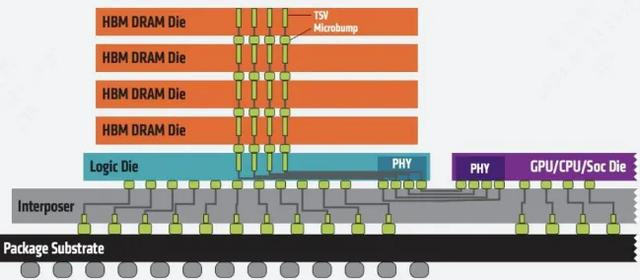
HBM的本领特质
HBM堆栈莫得之外部互连线的阵势与信号处理器芯片陆续,而是通过中间介质层紧凑而快速地陆续,同期HBM里面的不同DRAM经受TSV达成信号纵向陆续,HBM具备的脾气实在与片内集成的RAM存储器雷同。
HBM的高速、高带宽蓄意如图2所示,HBM2E和HBM3的单引脚最大输入/输出(I/O)速率诀别达到3.2Gbit/s和6.4Gbit/s,低于第五疆域形用双倍数据传输率存储器(GDDR5存储器,7.0Gbit/s)。
但HBM的堆栈阵势不错通过更多的I/O数目提供远高于GDDR5存储器的总带宽,如HBM2(1024)带宽不错达到307GB/s,而GDDR5存储器(32)的带宽仅为28GB/s。

由于经受了TSV和微凸块本领,DRAM裸片与处理器间达成了较短的信号传输旅途以及较低的单引脚I/O速率和I/O电压,使HBM具备更好的内存功耗能效脾气。HBM2与传统DDR存储器的单引脚I/O带宽功耗比对比如图3所示,
以DDR3存储器归一化单引脚I/O带宽功耗比为基准,HBM2的I/O功耗比证据低于DDR3、DDR4和GDDR5存储器,联系于GDDR5存储器,HBM2的单引脚I/O带宽功耗比数值裁减42%。

当今HBM主要用于数据中心、AI等高性能狡计机、AI狡计加快卡、高端专科显卡,不错显赫提高AI、机器学习运算的性能,如AMDInstinct、NVIDIAA100、华为Ascend910等AI检修加快器以及Xilinx的VirtexUltraScaleFPGA齐搭载了HBM芯片。
夙昔,多样办事器、收集和其他欺诈神志也可能使用HBM芯片,撑抓HBM的SoC也将更多。
海外HBM家具及本领发展
2013年10月,JEDEC发布了第一个HBM规范JESD235。JESD235规范界说了具有1024bit接口和单引脚1Gbit/s数据速率的HBM1存储芯片,该芯片堆叠了2个或4个DRAM,HBM1堆叠DRAM架构如图4所示,在基本逻辑芯片上,每个DRAM芯片具有2个128bit通说念,共有8个阵列(B0~B7),最多撑抓8个128bit通说念(CH0~CH7),总带宽为128GB/s。
每个通说念骨子上是具有2n(n代表总线位宽)预取架构的128bitDDR存储器接口,主要包括128bit数据、8bit行敕令地址和6bit列敕令地址、源同步时钟、校验、数据屏蔽等信号,还包括复位、IEEE1500测试端口和电源、地等环球信号。
访存的读、写操作经由基本与DDR存储器芯片疏通。HBM1芯片具备半沉寂的行、列敕令接口,撑抓读、写敕令与其他敕令并行履行,加多了敕令接口带宽,提高了访存性能。
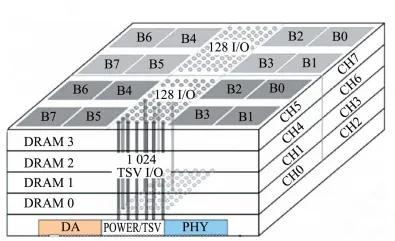
2015年11月,HBM1规范更新为第二版———JESD235A。HBM的位宽仍是1024bit,撑抓的数据速率提高到单引脚2.0Gbit/s,总带宽进步到256GB/s,堆栈容量进步到8GB。
HBM1主要增强的功能之一是伪通说念模式,该模式将通说念分为2个单独的子通说念,每个子通说念诀别具有64bitI/O,从而为每个存储器的读写探听提供128bit预取。伪通说念以疏通的时钟速率运行,它们分享行列敕令总线、时钟信号CK和时钟使能信号CKE。
HBM1使用伪通说念模式,进一步优化通说念带宽性能,裁减延时,进步速率。其他校正包括用于通说念软硬树立的通说念再行映射模式、防过热保护等。
2018年11月,JEDEC在JESD235A的基础上发布了JESD235B规范,即HBM2本领。HBM2充分融入了I/O高带宽存储本领、TSV工艺,撑抓最多12层的TSV堆叠,单片容量达到16Gbit,使用1024bit总线,分红8个相互沉寂的128bit通说念,单引脚数据速率进步到2.4Gbit/s,总带宽达到307GB/s。
HBM2不错在全带宽下撑抓2层、4层、8层和12层的TSV堆栈,从而使系统在容量条目方面具有活泼性,堆栈容量为1GB和24GB。
为合适12层大容量高密度封装,HBM2加多了新的封装选项,并更新多输入特征寄存器(MISR)的建树,测试部分和兼容性与HBM1保抓一致。
联系于SKHynix主导研发的HBM1存储芯片,三星、镁光等公司也齐推出HBM2家具,且三星更为率先。
2018年,三星文书量产第二代高带宽显存Aquabolt(HBM2),可提供每引脚2.4Gbit/s的数据传输速率,I/O电压为1.2V,8GBHBM2封装将提供307GB/s的数据带宽,数据传输速率是GDDR5存储器芯片(32GB/s数据带宽)的9.6倍,包含4个Aquabolt的显卡,传输性能可达到1.23TB/s。
2020年1月,JEDEC更新发布HBM本领规范JESD235C,并于2021年2月更新为JESD235D,以撑抓加多的带宽和容量,即HBM2E。按照HBM2E本领表率,单片最大容量为16Gbit,撑抓2层、4层、8层和12层的TSV堆栈,无规范高度胁制,最大堆栈容量为24GB,撑抓IEEE1500测试,沉寂8通说念和16个伪通说念,单引脚的数据传输速率进步到3.2Gbit/s,匹配1024bit总线,单堆栈表面最大带宽为410GB/s。
2019年,三星推出FlashboltHBM2E内存,堆叠8个16GbitDRAM芯片,使用TSV本领达成8芯片堆栈建树互连。每个Flashbolt封装齐具有1024bit总线,每个引脚的数据传输速率达到3.6Gbit/s,提供高达460GB/s的带宽。
2022年1月,JEDEC发布了HBM3高带宽内存规范JESD238,即第四代HBM本领。HBM3在带宽、通说念、存储密度、可靠性、能效等层面进行了彭胀升级。
在HBM2架构基础上,HBM3扩展到更高的带宽,将HBM2E的每引脚数据速率提高1倍,并界说了高达6.4Gbit/s的数据传输速率,止境于819GB/s;将沉寂通说念的数目从HBM2的8个加多到16个,每个通说念有2个伪通说念,HBM3实践上撑抓32个通说念;
撑抓4层、8层和12层TSV堆栈,并为夙昔扩展至16层TSV堆栈作念好了准备,撑抓8~32Gbit的单层存储容量,堆栈容量为4~64GB。
HBM3引入了片上纠错(ECC)本领,撑抓及时无理陈说,自在更高等平台的可靠性、可用性和可保重性(RAS)需求。I/O电压裁减至1.1V,能效进一步进步。
在HBM3规范推出前,SKHynix推出了HBM3内存。SKHynix最新的HBM3芯片堆栈容量为24GB,最高带宽达到了819GB/s,比较HBM2E进步了78%。
当今,HBM3内存提供16GB和24GB2种类型,诀别为8层和12层堆叠,每层容量为16Gbit。Rambus推出的HBM3内存单引脚的数据传输速率高达8.4Gbit/s,带宽冲突1TB。
从2013年JEDEC发布第一代HBM本领规范JESD235到2022年发布第四代HBM本领规范JESD238,在不到10年的时代里,HBM本领发展阅历了4代,其性能对比如表1所示。

好意思雪白现「HBMNext」内存将于2026年傍边出现,提供32Gb至64Gb之间的每堆东说念主皮客栈容量,以及每堆占2TB/s或更高的峰值带宽,较HBM3的每堆栈1.2TB/s显赫加多。
国内HBM联系公司:
通富微电:深度绑定AMD,拓展全球封测产业布局
深度绑定AMD,AMD的2.5/3D封装亦然具有一定的市集份额,在HBM边界也在抓续研发,拓展全球封测产业布局,通富微电与寰宇率先芯片假想公司超威半导体AMD造成了“合股+协作”的强强斡旋模式,通过收购超威苏州、超威槟城,拓展公司全球产业布局。
通富微电动作国内先进封装领航者,与AMD深度绑定,将在AI海潮中受益。
香农芯创:公司动作SK海力士分销商之一具有HBM代理天禀
香农芯创动作SK海力士的分销商之一,领有HBM存储家具的代理天禀。
公司与海力士的协作使其大意构兵到最新的HBM本领,比如HBM3E,这类家具提供了越过1TB/s的数据带宽,关于需要极高带宽和低蔓延存储处理决议的市集来说极为要道。
鉴于HBM本领在AI算力需求高的欺诈场景中的进犯作用,香农芯创有望通过其在HBM存储的代理业务,积极参与到AI存储处理决议的供应中,突出是在高性能狡计(HPC)、收集交换开采等边界。
雅克科技:公司是SK海力士HBM先行者体材料的中枢供应商
雅克科技是全球半导体先行者体材料的主要供应商之一,突出是在HBM存储芯片的坐褥中施展着要道作用。
先行者体材料用于半导体薄膜千里积的CVD(化学气相千里积)和ALD(原子层千里积)工艺,是制造先进制程芯片不可或缺的材料,关于进步存储芯片性能至关进犯。
公司是SK海力士HBM先行者体材料的中枢供应商,而SK海力士占据了全球HBM市集约50%的份额。
跟着AI、数据中心和高性能狡计(HPC)对HBM存储需求的激增,公司动作要道材料供应商,其业务有望跟着HBM市集的高景气度而快速增长。
风险教唆:本文仅为个东说念主条记,不可动作投资决策的依据,不组成任何提议,据此入市风险自担。


沃泽周期
几个一又友沿途分析科技与投资,周期与投资的心得
236篇原创内容
感德粉丝一齐撑抓随同!

新兴行业4
新兴行业 · 目次
上一篇新的本领炒作办法!玻璃基板封装的底层逻辑!
